玻璃基板,來勢洶洶
最近,備受關注的“玻璃基板”,便是其中之一。
從Intel的率先入局,到三星、LG等企業聞風而入,以及日前蘋果的看好信號,一系列密集的動作背後,用玻璃材料取代有機基板似乎正在成爲業內共識,或者至少是未來一個非常重要的技術路徑。
當前已有不少企業在着手研發玻璃基板和相關技術。
封裝基板,迎來新革命
那么,玻璃基板究竟有什么優勢,能引得多家大廠悉數前來?
有業內人士指出,隨着對更強大計算的需求增加,半導體電路變得越來越復雜,信號傳輸速度、功率傳輸、設計規則和封裝基板穩定性的改進將至關重要。
在此趨勢下,塑料基板(有機材料基板)很快就會達到容納的極限,特別是它們的粗糙表面,會對超精細電路的固有性能產生負面影響;此外,有機材料在芯片制造過程中可能會發生收縮或翹曲,導致芯片產生缺陷。隨着更多的硅芯片被封裝在塑料基板上,翹曲的風險也會增加。
因此,半導體行業需要一款新型的基板。
作爲新型方案,玻璃基板有比塑料基板更光滑的表面,同樣面積下,开孔數量要比在有機材料上多得多。據悉,玻璃芯通孔之間的間隔能夠小於 100 微米,這直接能讓晶片之間的互連密度提升10倍。互連密度的提升能容納的更多數量的晶體管,從而實現更復雜的設計和更有效地利用空間;
同時,玻璃基板在熱學性能、物理穩定度方面表現都更出色,更耐熱,不容易因爲溫度高而產生翹曲或變形的問題;
此外,玻璃芯獨特的電氣性能,使其介電損耗更低,允許更加清晰的信號和電力傳輸。這樣一來,信號傳輸過程中的功率損耗就會降低,芯片整體的效率也就自然而然被提上去了。與ABF塑料相比,玻璃芯基板的厚度可以減少一半左右,減薄可以提高信號傳輸速度和功率效率。
綜合來講,玻璃芯基板可顯著改善電氣、機械性能和熱穩定性,突破現有傳統基板限制。有專家表示,預計首批採用玻璃基板的產品將是高端高性能計算和人工智能芯片,這些產品是目前使用有機基板最喫力的產品。
而回顧基板的演進歷程可以發現,封裝基板在過去幾十年來已經經歷了多次轉變。
基板的需求始於早期的大規模集成芯片,隨着晶體管數量增加,需要將它們連接到更多的引腳上。最早的芯片封裝,如雙列直插式封裝,使用框架來固定硅芯片和提供信號路徑。
自上世紀70年代以來,基板設計不斷演變,包括金屬框架、陶瓷芯片和有機封裝。
不難發現,每次迭代的基板都比上一次具有更好的性能,從而可以更輕松地將大量信號和電源引腳布线到日益復雜的芯片上。
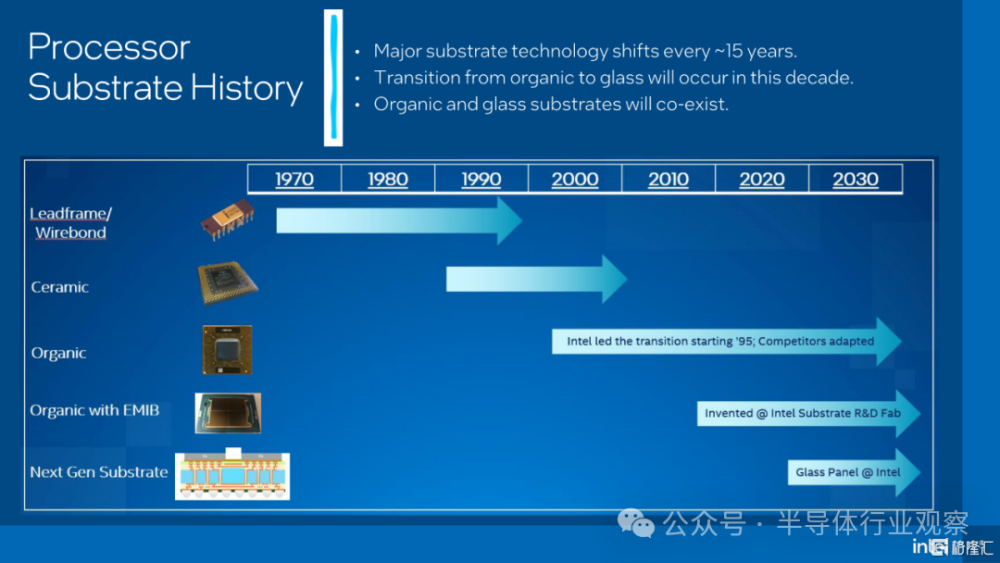
雖然現在仍會看到引线框架和陶瓷芯片,但有機基板在過去幾十年中一直是該行業的支柱。
值得注意的是,英特爾在實現用於下一代封裝的技術創新方面有着悠久的歷史和經驗積累。早在20世紀90年代,英特爾引領了業界從陶瓷封裝向有機封裝的過渡,也是第一個實現滷素和無鉛封裝的公司,並發明了先進的嵌入式芯片封裝技術和業界領先的主動式3D封裝技術。
如今,隨着有機基板逐漸達到能力極限。英特爾又开始率先在尋找有機基板的真正替代品,一種能夠與大型芯片完美配合的基板,這雖然不能在最高級別取代 CoWoS/EMIB 的需求,但可以提供比當前有機基板更好的信號性能和更密集的布线。
按照英特爾所說,在過去的十多年來裏,公司一直在研究和評估玻璃基板作爲有機基板替代品的可靠性。
行業玩家,競逐玻璃基板賽道
作爲封裝基板領域的探索引領者,2023年9月,英特爾推出基於下一代先進封裝的玻璃基板开發的最先進處理器,計劃於2026~2030年量產。
英特爾表示,玻璃基板具有卓越的機械、物理和光學特性,能夠構建更高性能的多芯片SiP,在芯片上多放置50%的裸片,從而可以塞進更多的Chiplet。憑借單一封裝納入更多晶體管,預計將實現更強大的算力。
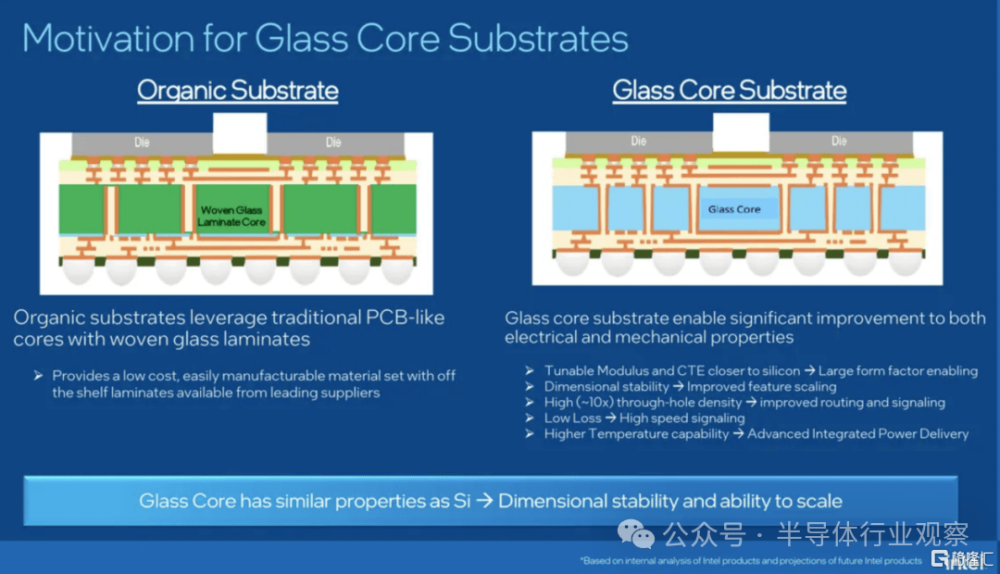
同時,爲了彌合機械和電氣之間的差距,英特爾能夠在玻璃通孔(TGV)上實現更緊密的間距,將TGV的間距控制在100μm以內,從而允許整體上有更多數量的通孔,將TGV密度提高10倍。所有這些最終使得通過基板核心路由信號變得更加靈活,並且在某種程度上使得使用更少的RDL層路由信號變得更加容易。
英特爾稱該成果將重新定義芯片封裝的邊界,能夠爲數據中心、人工智能和圖形構建提供改變遊戲規則的解決方案,推動摩爾定律進步。
值得一提的是,英特爾認爲玻璃基板的特性非常適合Chiplet,由於小芯片設計對基板的信號傳輸速度、供電能力、設計和穩定性提出了新的要求,在改用玻璃基板後就可以滿足這些要求。
衆所周知,英特爾一直致力於推動Chiplet的發展,並且拉動一批頭部大廠組成UCIe聯盟,旨在降低小芯片先進封裝技術的設計成本,實現小芯片之間的互聯制定統一。這次搶跑玻璃基板工藝,其背後大概也有引領行業標准的“私心”。
英特爾表示,針對玻璃基板方面的相關研究工作可以追溯到十年前,並且已經在美國亞利桑那州投資超過10億美元,用於建設研發產线。
英特爾在業界率先推出用於先進封裝的玻璃基板,一方面延續了近期PowerVia和RibbonFET等技術突破的良好勢頭,展現了英特爾對Intel 18A制程節點之後的下一個計算時代的預先關注和展望。
另一方面,這或許也是英特爾從封裝測試下手,應對台積電新策略。
目前,英特爾正朝着2030年在單個封裝上集成1萬億個晶體管的目標前進,而包括玻璃基板在內的先進封裝技術的持續創新將有助於實現這一目標。
而就在近日,據韓媒sedaily報道,三星已經成立了專門的團隊,研發“玻璃基板”技術。
三星集團子公司三星電機宣布與三星電子和三星顯示器等主要電子子公司建立聯合研發(R&D)統一战线,研發玻璃基板,並將在2026年开始大規模量產,旨在比十年前進入玻璃基板研發的英特爾更快地實現商業化。
組建“軍團”加碼研發,這足以見得三星集團對玻璃基板的重視。
英特爾和三星的積極部署,可以理解爲是其迎战台積電的一大策略。當前,在先進工藝領域台積電依舊領先,而在先進封裝領域台積電CoWoS實力雄厚,擁有較高的專利壁壘,英特爾和三星除在工藝層面加緊布局之外,先進封裝領域也需要尋求新的路徑實現追趕甚至超越,而玻璃基板成爲一個最佳的“跳板”。
至於台積電的“隱忍”,有行業專家表示,台積電雖還沒有相關動作,但應該也在密切關注。台積電在CoWoS領域火力全开,接連獲得大廠訂單享受紅利,因而並不急於投入巨資押注玻璃基板,仍將繼續沿着現有路徑升級迭代,以保持領先地位不可撼動。而一旦台積電覺得時機成熟,將會大幅加碼。
而在這項技術領域中,除了英特爾和三星,已有多個強勁對手入局。
3月25日,LG Innotek CEO Moon Hyuk-soo在回答有關發展半導體玻璃基板業務的問題時表示:“我們半導體基板的主要客戶是美國一家大型半導體公司,該公司對玻璃基板表現出極大的興趣。當然,我們正在爲此做准備。”
日本DNP展示了半導體封裝的一項新开發成果——玻璃芯載板 (GCS:Glass Core Substrate),據稱可以解決ABF帶來的許多問題,准備在2027年量產。
DNP聲稱,其具有玻璃芯的HDI載板與基於有機樹脂的載板相比具有更優越的性能。據介紹,使用玻璃芯載板 (GCS) 可以實現更精細的間距,因此可以實現極其密集的布线,因爲它更硬並且不易因高溫而膨脹。DNP展示的示意圖甚至完全從封裝中省略了細間距載板,暗示這部分可能不再需要。
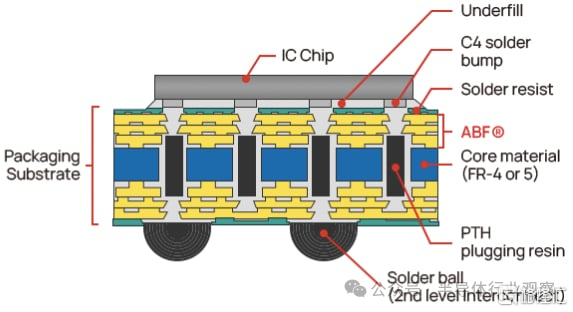
要說最早入局玻璃基板的,還得是韓國SK集團旗下的Absolics。Absolics 2021年在世界上首次开發的“高性能計算(HPC)用玻璃基板”指定爲新的增長動力。去年,Absolics又投資了6億美元,計劃在喬治亞州科文頓建一座月產能達4000塊的玻璃基板工廠。
Absolics看好玻璃帶來的機會,將其視爲半導體封裝的改革者。
Absolics表示,隨着微處理的性能提升已達到極限,半導體行業正在積極利用異構封裝,但現有的半導體載板必須通過稱爲硅中介層的中間載板連接到半導體芯片,而內置無源元件的玻璃載板可以在相同尺寸下集成更多的芯片,功耗也減少了一半。
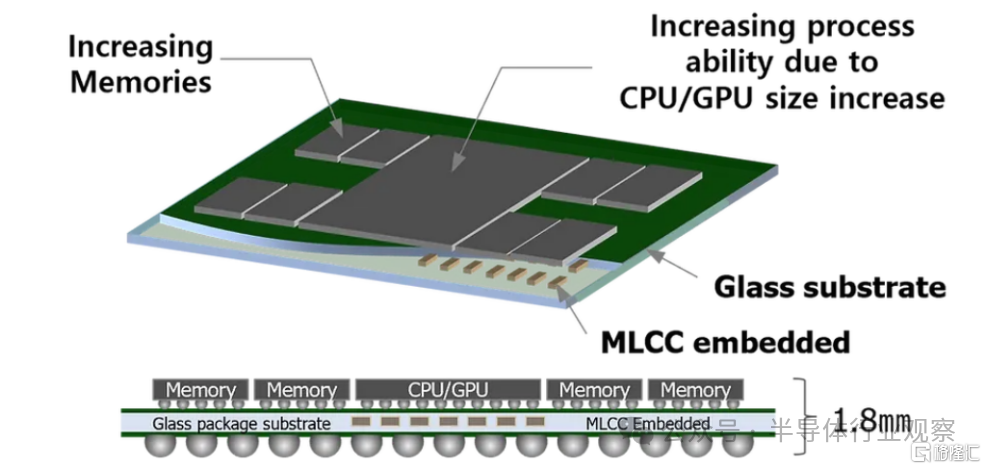
圖源:Absolics
作爲全球第一大基板供應商,日本Ibiden也在去年10月宣布,擬將玻璃基板作爲一項新業務研發。據知情人士透露,當前Ibiden正處於半導體封裝用玻璃芯基板技術的探索階段。
另外,玻璃大廠康寧也看好玻璃在載板中的機會。他們認爲,玻璃的諸多特性優勢是應對傳統封裝材料挑战的絕佳解決方案。康寧公司正在積極探索400G及以上的集成光學解決方案,集成電光玻璃基板將被應用於CPO工藝中。
有業內人士指出,從行業整體來看,目前國外廠商對於玻璃基板的布局份額處於領先地位,包括美國康寧、美國申泰、日本泰庫尼思科和KISO WAVE等。而國內方面,沃格光電、廈門雲天半導體等企業也取得不同程度進展。
需要注意的是,目前國內與國外的差距更多是體現在裝備方面,相關裝備被美日德壟斷,國產替代道阻且長。畢竟裝備方面的追趕不是一朝一夕的,但是從工藝技術角度开發角度來看,國產廠商或存在彎道超車的可能。
玻璃基板挑战尚存,TGV成行業熱點
作爲新生事物,玻璃基板仍有現實的諸多挑战需要解決。
加工挑战:玻璃基板的加工面臨着巨大挑战,這些挑战包括鑽孔和填孔的優化,需要考慮對脆性的處理、金屬线的粘附性不足,以及實現均勻的過孔填充和一致的電氣性能。同時,選擇適合各項指標的玻璃材料、玻璃邊緣的抗裂性、高縱橫比、金屬化、提高良品率、大塊玻璃基板的切割,以及產品整個生命周期內的散熱和承受機械力,都是需要克服的技術難題。
缺乏可靠性數據:與傳統的BT/ABF等基板相比,玻璃基板的長期可靠性信息相對不足。這包括建立玻璃基板可靠性數據庫,涵蓋機械強度、耐熱循環性、吸溼性、介電擊穿和應力引起的分層等方面。建立這些數據庫可能需要數十年的數據積累,以制定標准、性能指標和預期壽命,這些因素最終會影響制造商的決策和投入。解決這些挑战需要跨學科的合作和長期的研究投入,以改善玻璃基板的制造工藝和性能,進而推動玻璃芯技術在各個領域的應用和發展。
制造和測試挑战:由於玻璃基板較脆,還需要重新开發制造設備。且由於玻璃的透明度高且反射率與硅不同,因此爲測試帶來了獨特的挑战,如依靠反射率來測量距離和深度可能會導致信號失真或丟失,從而影響測量精度。
有限的層數:玻璃基板的前景在於支持高密度互連的能力,這是下一代電子產品所必需的。但目前這種潛力因建設過程中的實際限制而受到限制。目前用於半導體封裝基板通常允許多層電路,包括頂部和底部以及內部層。這種分層對於實現多芯片模塊和復雜集成電路中所需的電氣路徑至關重要。然而,由於玻璃的物理特性,例如其剛性和TGV使用的方法,添加內層是有問題的。
成本挑战:成本也十分關鍵。即使技術上擁有優勢,但降低成本也是一大難題,何時能夠用上高性價比的玻璃基板還不確定。
另一邊,TGV技術正在成爲當前先進封裝的研究熱點。
TGV,Through Glass Via,又稱玻璃通孔工藝,是穿過玻璃基板的垂直電氣互連。與TSV(Through Silicon Via)相對應,作爲一種可能替代有機基板通孔互連的新技術,TGV被認爲是下一代先進封裝的關鍵技術。
TGV以高品質硼硅玻璃、石英玻璃爲基材,通過種子層濺射、電鍍填充、化學機械平坦化、RDL再布线,bump工藝引出實現3D互聯。TGV是直徑通常爲10μm-100μm的微通孔。對於先進封裝領域的各種應用,每片晶圓上通常需要應用數萬個TGV通孔並對其進行金屬化,以獲得所需要的導電性。
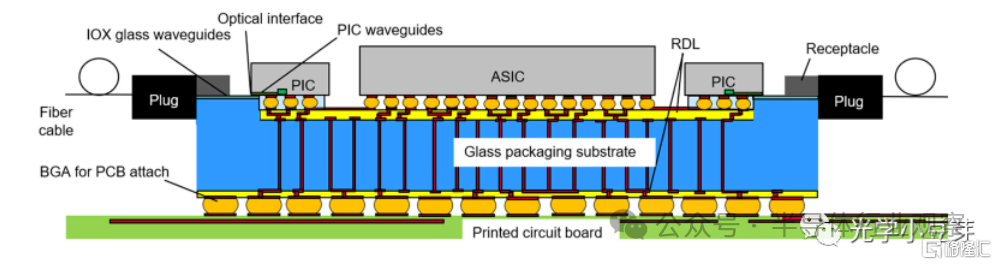
圖源:光學小豆芽
與TSV工藝相比,TGV擁有諸多優勢,比如:優良的高頻電學特性、大尺寸超薄玻璃襯底易於獲取、機械穩定性強等。因此,TGV技術被廣泛應用於射頻組件、光電器件、MEMS器件,以及高密度系統集成等領域。
但有行業專家向筆者表示,TGV技術面臨的關鍵問題是沒有類似硅的深刻蝕工藝,難以快速制作高深寬比的玻璃深孔。傳統的噴砂法、溼法刻蝕法和激光鑽孔法等都存在一定局限性。感應耦合等離子體幹法刻蝕技術控制精度高,刻蝕表面平整光滑,垂直度好,常用於刻蝕高深寬比結構,但各向同性刻蝕嚴重。由於玻璃襯底上掩膜沉積工藝的限制,在深孔刻蝕時,需要一定的刻蝕選擇比。在保證側壁垂直性與刻蝕選擇比的同時提高玻璃刻蝕速率成爲目前研究的難點。
對於玻璃基板和TGV面臨的挑战和行業進展,沃格集團副總裁,研究院院長張迅表示,目前玻璃基板或搭載玻璃基板的芯片正處在量產前准備階段。沃格從2018年上市之後就致力於TGV技術的研發,目前已經掌握了該技術的核心工藝及制程能力,目前已經與國內外大客戶建立了良好的聯系。
但從行業整體進程來看,玻璃基板在先進封裝領域的研發尚處於初期階段,行業仍未形成標准化和規模化。與每項新型技術相同,其發展初期需要大量資金投入以及周期迭代。尤其是TGV通孔技術,各個廠家的制備方法不盡相同,產品良率和成本的控制是大家共同面臨的挑战。
“玻璃基板”市場點燃之後,生態是重中之重
目前,盡管玻璃基板和TGV應用市場尚未大規模啓用,但許多半導體廠商已开始競相入局玻璃基板和TGV領域,積極參與構建相關生態系統。
縱觀行業格局,目前全球TGV市場份額高度集中,核心技術、高端產品仍掌握着國外先進企業中。據News Channel Nebraska Central 2022年數據顯示,美國是最大的TGV晶圓市場,擁有約46%的市場份額。歐洲緊隨其後,約佔25%的市場份額。在TGV晶圓市場的主要參與者中,全球前五名廠商佔有率超過70%。
而國內玻璃晶圓產能增長趨勢也較爲顯著。預計在2024年至2026年期間,國內將擁有超過160萬片/月的設計產能。
近兩年,一些國內公司正在爲先進封裝而設計的TGV產品進入送樣到試量產的階段。例如,上文提到的沃格光電和雲天半導體。
沃格光電是國內玻璃基板領先企業,是國內少數掌握TGV技術的廠家之一,具備行業領先的玻璃薄化、TGV、濺射銅以及微電路圖形化技術,擁有玻璃基巨量微米級通孔的能力,最小孔徑可至10μm,厚度最薄50μm,线寬线距小至8μm。
廈門雲天半導體也成功开發了先進TGV激光刻蝕技術,面向應用MEMS、Fluidic、PCR、Inkjet、CPO。基於玻璃成孔理論研究和工程實踐,可以在50-500μm厚的玻璃上形成孔徑7μm的玻璃通孔/盲孔,具有較好的表面和孔內粗糙度、孔型圓度。
此外,包括賽微電子、成都邁科、三疊紀、五方光電、帝爾激光、蘇州甫一電子、藍特光學、蘇州森丸電子等在內的國內廠商也在玻璃基板和TGV領域展开深入研究,並取得一定的成果和突破。
這表明了國內在半導體封裝領域的發展和創新,以及對玻璃基板技術的積極探索和應用。隨着這些技術的成熟和應用的推進,國內半導體產業有望在未來取得更大的發展成果,並在全球市場上發揮更加重要的作用。
值得注意的是,玻璃基板產業需要走合作路线,不是一個“單打獨鬥”就能勝出的投入。
英特爾與著名玻璃加工公司LPKF和德國玻璃公司Schott合作,致力於玻璃基板的商業化。還與賓夕法尼亞州立大學領導了一項全國性的努力,有十多所著名大學和材料、零部件和設備公司在玻璃基板研究方面進行合作。
而三星組建的半導體玻璃基板研發聯盟,也是三星電機首次與三星電子和三星顯示器等電子元件子公司一起進行玻璃基板研究。有分析稱,三星電子預計將掌握半導體和基板相結合的專業知識,而三星顯示器預計將承擔玻璃加工等角色,預計三星電機將通過與聯盟最大限度地發揮研發協同效應,但玻璃基板生態系統將如何發展還有待觀察。
英特爾、三星等掀起玻璃基板浪潮,促使整個供應鏈也積極努力,頭部廠商的入局肯定能加速技術實現的進程。但這需要所有的供應鏈廠商合力,才能逐步克服相關的挑战。
作爲國內玻璃基板行業的佼佼者,沃格集團副總裁,研究院院長張迅也向筆者表示,每個行業建設商業生態系統都需企業結伴同行。比如在產業發展初期,最需要的是資金。對於創業者而言,需要對自己的技術有信念,勇於推銷自己的產品,吸引政府或頭部公司對新型技術投入資源。另外,需要各家公司聯合起來,制定行業標准,規範生產過程,簡化开發周期,降低生產成本,增強質量保證,便於下遊企業的使用。
總的來說,玻璃芯基板的良性發展需要產業鏈上下遊建立一個完整的生態系統。從材料端層層向下到制程端、設備端等,都需要革新。材料選擇、制程工藝的選擇、自動化傳輸、結構堆棧的設計這些都會影響最後的良率,供應鏈需進行一番整合,才有辦法達成量產的可能性。
從當前行業進展來看,封裝基板要過渡到玻璃基板,預計還需要一些時間。
結語
綜合來看,具有更密集布线和更高信號性能的玻璃基板,在先進封裝中受到關注。
雖然仍存在諸多挑战,如堆積、應力和處理問題,以及缺乏可靠性數據等,但其無與倫比的平整度和熱性能爲下一代緊湊型高性能封裝提供了基礎,其潛在優勢讓這些挑战和復雜性變得黯然失色。
隨着對更緊湊和復雜設備的需求日益增長,玻璃基板或將在未來發揮重要作用。
從行業進展來看,英特爾深潛十年、SK已在美國建廠並准備量產,日本企業DNP也在加快事業的步伐。最近,三星、LG也正式進軍,加上國內相關企業的積極布局,點燃了“玻璃基板”市場的新競爭。
雖然英玻璃基板的出現讓大家感到震撼,但從業界的步伐看來,這個技術離量產還有一段時間。在短時間內,芯片基板市場的主流還依舊會是有機材料,畢竟技術迭代完成商業化轉身也需要一個過渡時期,技術成本、良率等都是廠商需要解決的問題。
張迅坦言:“每項技術的落地都需要天時、地利、人和。但就目前市場發展形式而言,越來越多的頭部公司、科研單位關注到了玻璃基板的性能優勢,並投入到研發當中。所以我們相信隨着各家技術的創新更迭,距離玻璃基板的爆發已經越來越近。”
有預測稱,一旦實現玻璃基板的規模商業化,其將成爲基板行業新的遊戲規則改變者。
標題:玻璃基板,來勢洶洶
地址:https://www.iknowplus.com/post/95170.html







